3月5日消息,日立当地时间2月27日称该企业已开发出了一种高灵敏度半导体缺陷检测技术,可通过机器学习的辅助检出10nm及更小尺寸的微缺陷。这项技术已在二月末的SPIE先进光刻与图案化2025学术会议上展出。
随着对高性能芯片的需求不断增加,半导体制造商对生产中的质量控制愈发重视;而制程的微缩也意味着能直接影响性能的缺陷尺寸门槛逐渐降低,对缺陷检测灵敏度的要求进一步提升。日立的这一技术就是在该背景下应运而生的。
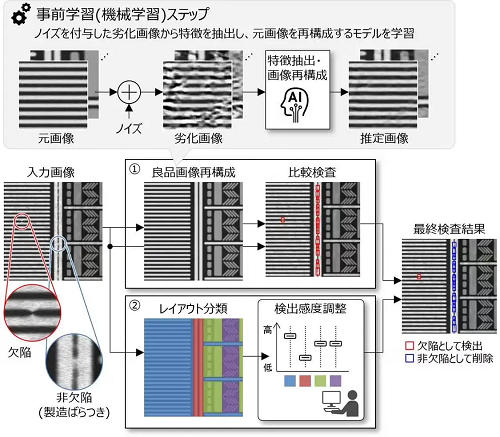
日立的机器学习缺陷检测技术主要包含两大部分,即图像重建对比和过度检测抑制:
图像重建对比:检测系统首先通过大量添加噪点的“人造”缺陷图像学习微缺陷的数据特征;实际使用时对扫描电镜照片尽量进行无缺陷版本重建,并对原始图像和重建图像进行对比,从而检出缺陷。
过度检测抑制:由于先进半导体制程的微缩,差异化功能电路和缺陷在图像上的区别逐渐模糊,而机器学习检测系统可对电路布局进行分类,并根据电路特征调整灵敏度,可减少90%的过度检测。
发布日期: 2024-04-26
发布日期: 2024-10-22
发布日期: 2024-05-14
发布日期: 2024-07-22
发布日期: 2024-06-24
发布日期: 2024-07-08
发布日期: 2024-04-12
发布日期: 2024-06-07
发布日期: 2025-04-14
发布日期: 2025-04-14
发布日期: 2025-04-14
发布日期: 2025-04-14
发布日期: 2025-04-14
寻找更多销售、技术和解决方案的信息?
广州绿测电子科技有限公司(简称:绿测科技)成立于2015年11月,是一家专注于耕耘测试与测量行业的技术开发公司。绿测科技以“工程师的测试管家”的理念向广大客户提供专业的管家服务。绿测科技的研发部及工厂设立于广州番禺区,随着公司业务的发展,先后在广西南宁、深圳、广州南沙、香港等地设立了机构。绿测科技经过深耕测试与测量领域多年,组建了一支经验丰富的团队,可为广大客户提供品质过硬的产品及测试技术服务等支持。




技术工程师

020-22042442



